Відмінною особливістю електронних технологій останнього часу є все більше ущільнення монтажу компонентів і мікросхем, що стало причиною появи корпусів типу BGA (англ. Ball grid array – масив кульок). Цей самий масив знаходиться під корпусом мікросхеми, що дозволяє розмістити велику кількість виходів у малому обсязі (корпусу). При їх пайку обробляється відразу кілька контактних ніжок і майданчиків, що розташовані під нижньою частиною цифрового контролера або невеликого за розмірами чіпа. Діяти з ними слід дуже акуратно, пайка вимагає спеціалізованого обладнання, навичок, знання технологій і професіоналізму.
Що таке bga пайка?
Пайка BGA мікросхем або реболінг (reballing) – це процес відновлення масиву з кульок на нижньому майданчику плати. У нас цей термін не дуже прижився і самі фахівці цей процес ремонту називають просто перекатую контактних кульок. Необхідність в цій процедурі виникає у випадках, коли потрібно замінити згорілу мікросхему, попередньо випаявши її з місця.

Саму процедуру можна розділити на основні етапи:
- демонтаж несправного мікроелемента після нагрівання;
- очищення опорної плати від залишків старого припою;
- накочення нових контактних виводів;
- установка компонента на місце.
Слід зазначити, що якість пайки значно відрізняється при роботі на професійних паяльних станціях і в домашніх умовах на кустарних пристосувань. До того ж BGA пайка вимагає досвіду, знання елементної бази, хорошого окоміру і якісних витратних елементів. Маючи професійну станцію, ремонт стане значно простіше і пройде в напівавтоматичному режимі.
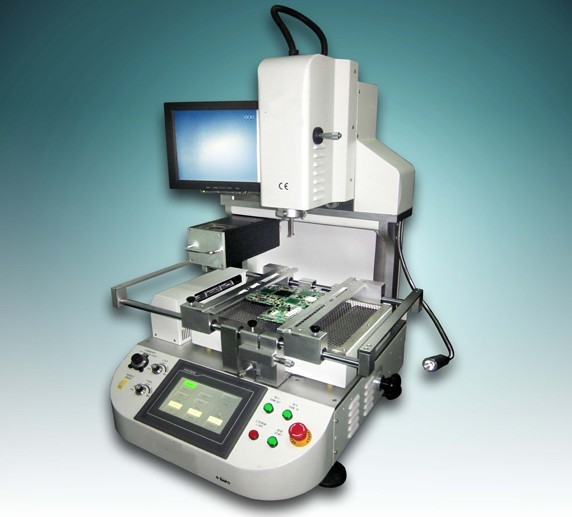
Для роботи з BGA чіпами будуть потрібні наступні інструменти, матеріали і пристосування:
- паяльна станція з термофеном;
- зручний пінцет;
- спеціальна паяльна паста і фірмовий флюс;
- потрібний трафарет для нанесення паяльної пасти;
- липка стрічка для видалення припою;
Переваги та недоліки bga пайки
Переваги
ВИСОКА ЩІЛЬНІСТЬ
BGA – це розв’язання проблеми виробництва мініатюрного корпусу ІС з великою кількістю виводів. Масиви виводів при використанні поверхневого монтажу «дві лінії з боків» (SOIC) виробляються все з меншим і меншим відстанню і шириною виводів для зменшення місця, займаного виводами, але це викликає певні складності при монтажі даних компонентів. Виводи розташовуються дуже близько, і росте відсоток браку через споювання припоєм сусідніх контактів. BGA не має такої проблеми – припій наноситься на заводі в потрібній кількості та потрібному місці.
Недоліки
НЕГНУЧКІ ВИВОДИ
Основним недоліком BGA є те, що виводи не є гнучкими. Наприклад, при тепловому розширенні або вібрації деякі виводи можуть зламатися. Тому BGA не популярний у військовій техніці або авіабудуванні.
Частково цю проблему вирішує залиття мікросхеми спеціальним полімерним речовиною – компаундом. Він скріплює всю поверхню мікросхеми з платою. Одночасно компаунд перешкоджає проникненню вологи під корпус BGA-мікросхеми, що особливо актуально для деякої побутової електроніки (наприклад, мобільних телефонів). Також здійснюється і часткове залиття корпусу, по кутах мікросхеми, для посилення механічної міцності.
ДОРОГЕ ОБСЛУГОВУВАННЯ
Іншим недоліком є те, що після того, як мікросхема припаяна, дуже важко визначити дефекти пайки. Зазвичай застосовують рентгенівські знімки або спеціальні мікроскопи, які були розроблені для розв’язання даної проблеми, але вони дорогі. Щодо недорогих методів локалізації несправностей, що виникають при монтажі, є периферійне сканування. Якщо вирішено, що BGA невдало припаяна, вона може бути демонтована термоповітряним феном або за допомогою інфрачервоної паяльної станції; може бути замінена новою. У деяких випадках через дорожнечу мікросхеми кульки відновлюють за допомогою паяльних паст і трафаретів.
НЕМОЖЛИВІСТЬ ЗАМІНИ
Якщо у ноутбука, наприклад, в материнській платі центральний процесор має сокет такого формфактора, то в разі апгрейда або несправності його заміна без спеціального обладнання неможлива, оскільки в цьому випадку потрібно випаювати старий процесор і запаювати новий, не пошкодивши плату, не зачепивши та не перегрів встановлені поруч елементи. З цієї ж причини ускладнена заміна що вийшли з ладу мікросхем чипсета, які практично завжди реалізуються в BGA.